

扫码打开虎嗅APP
本文来自微信公众号:半导体行业观察 (ID:icbank),作者:IEEE,原文标题:《SiC,迎来劲敌》,题图来自:视觉中国
过去十年,半导体领域最大的故事之一就是电力电子领域意外超越传统硅的碳化硅(SiC)和氮化镓(GaN)占领了价值数十亿美元的细分市场。随着主要应用落入这些具有优越属性的新贵手中,一个问题自然而然地出现了。
下一个新型功率半导体是什么——其卓越的能力能否将从 SiC 和 GaN 手中夺取主要市场份额?
人们的注意力集中在三种候选材料上:氧化镓、金刚石和氮化铝(AlN)。它们都具有显著的特性,但也存在迄今为止阻碍商业成功的根本弱点。然而,现在,得益于最近的几项突破,包括名古屋大学在去年 12 月于旧金山举行的最新IEEE 国际电子器件会议上报告的一项技术进步,AlN 的前景已大大改善。

图1 日本名古屋大学制造的氮化铝二极管展示了半导体的显著潜力 图片来自:NAGOYA UNIVERSITY
一、氮化铝如何赶上SiC 和 GaN
IEDM 论文描述了基于氮化铝合金的二极管的制造方法,该二极管能够承受每厘米 7.3 兆伏的电场,这个数字大约是碳化硅或氮化镓所能承受的电场的两倍。值得注意的是,该器件在传导电流时也具有非常低的电阻。
“这是一个了不起的结果,”IEEE 高级会员、佐治亚理工学院电气与计算机工程教授W. Alan Doolittle说道。“特别是这个东西的导通电阻,非常好。” 名古屋大学的论文有七位共同作者,其中包括 IEEE 会员天野浩(Hiroshi Amano),他因发明蓝色 LED 而获得 2014 年诺贝尔奖。
氮化铝长期以来一直吸引着半导体研究人员。
功率半导体最重要的特性之一是其带隙。它是半导体晶格中的电子从价带跃迁到导带所需的能量,以电子伏特为单位,在导带中电子可以在晶格中自由移动并导电。在具有宽带隙的半导体中,例如氮化镓(GaN)或碳化硅(SiC),原子之间的键很强。因此,在键断裂和晶体管被破坏之前,该材料能够承受非常强的电场。但与 AlN 相比,它们都相形见绌。AlN的带隙为6.20电子伏特;对于 GaN,该值为 3.40;对于最常见的 SiC 类型,该值为 3.26。
AlN 的一个长期存在的问题是掺杂,即插入杂质元素,使半导体产生过量电荷,从而使其能够承载电流。化学掺杂 AlN 的策略近年来才开始出现,尚未完全成熟,其有效性在研究人员中是一个有争议的话题。在掺杂过程中,多余的电荷可以是电子,在这种情况下,半导体被称为“ n型”,或者它们可以是缺电子,称为空穴,在这种情况下,半导体是“ p型”。几乎所有商业上成功的器件都是由这种夹在一起的掺杂半导体组成。
但事实证明,杂质掺杂并不是掺杂半导体的唯一方法。
一些基于含有元素周期表中第 III 族(又名钪族)和第 V 族(钒族)元素的化合物的半导体(例如化合物氮化镓)具有不寻常且显着的特性。在两个这样的半导体相遇的边界处,即使没有化学掺杂,它们也可以自发地产生一个由极高移动性的电荷载流子组成的二维池(two-dimensional pool ),称为二维电子气( 2-dimensional electron gas)。
它是由晶体内部电场产生的,而晶体内部电场具有几个属性:其一,这些 III-V 族半导体的晶体具有不同寻常的极性:在晶体的晶胞( unit cells)内,电子云和带正电的原子核彼此偏移,足以为每个晶胞提供不同的负电区域和正电区域(偶极子:dipole)。此外,只需使晶格变形,就可以在这些半导体的晶格中产生电荷,这种现象称为压电(piezoelectricity)。
二、大进步背后的故事
2000 年代初期,加州大学圣塔芭芭拉分校的研究人员利用这些特性开发了一种称为分布式极化掺杂(distributed polarization doping)的技术,该技术使他们能够在没有杂质的情况下获得块状(三维)氮化镓的n型掺杂。
该小组包括 IEEE 院士Umesh Mishra(现任 UCSB 工程系主任)和他的研究生Debdeep Jena和Huili(Grace)Xing,两人现在都在康奈尔大学。Jena 和 Xing 都是 IEEE 院士,随后于 2010 年在康奈尔大学演示了p型分布式极化掺杂,然后于 2018 年在康奈尔大学演示了无掺杂剂二维空穴气体(hole gases)。
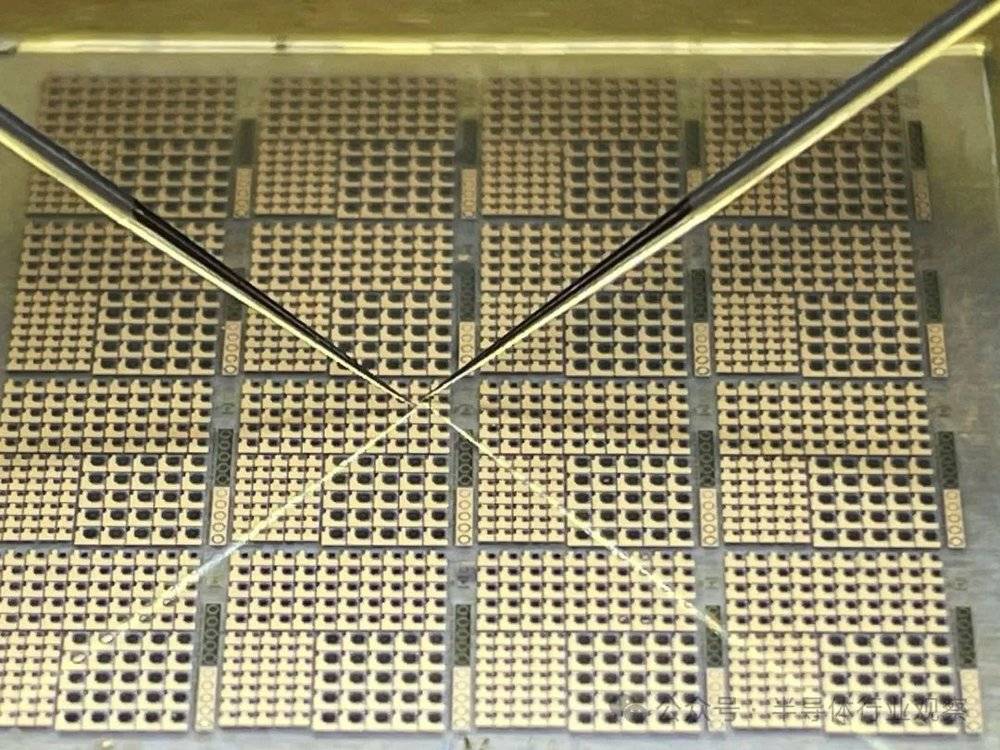
图2 最先进的氮化铝二极管正在进行测试 图片来自:NAGOYA UNIVERSITY
名古屋小组在这些先前成果的基础上,在氮化铝(或更准确地说,由 AlN 和 GaN 的混合物组成的铝镓氮化物 (AlGaN)合金)中实施无掺杂剂分布式极化掺杂技术。
与任何二极管一样,他们的器件具有与n掺杂区域配对的p掺杂区域,其间有一个称为结(junction)的边界。对于这两个区域,掺杂都是通过分布式偏振掺杂(distributed polarization doping)来完成的。他们通过在每个掺杂区域建立合金中 AlN 与 GaN 百分比的梯度,实现了不同的极化( n型和p型)。掺杂是n型还是p型仅取决于梯度(gradient)的方向。
Jena 表示:“铝成分不是均匀的 AlGaN 成分,而是以线性方式在空间上变化。” p掺杂层从邻近阳极接触一侧的纯氮化镓开始。向带有n掺杂层的结移动,AlGaN 合金中氮化铝的百分比增加,直到在结处达到 95% 的 AlN。继续沿相同方向移动,穿过n掺杂区域,AlN 的百分比随着距结的距离的增加而下降,从 95% 开始,到最低点为 70%,其中该层与纯 AlN 衬底接触。
“这是半导体器件的一个新概念,”名古屋器件的 Jena 说道。他补充道,下一步是制造一种在结点处有一层纯 AlN 的二极管,而不是 95% 的 AlN。根据他的计算,一层仅两微米厚的氮化铝就足以阻挡 3 千伏的电压。“这正是在不久的将来将会发生的事情,”他说。
在佐治亚理工学院,Doolittle同意这种说法,通过在未来的设备中加入更高含量的纯氮化铝,仍有巨大的改进空间。例如,名古屋二极管的击穿电场为 7.3 MV/cm,令人印象深刻,但 AlN 器件的理论最大值约为 15。更多的 AlN 也会大大提高热导率。导热能力对于功率器件至关重要,而 AlGaN 合金的导热率一般,低于 50瓦每米开尔文。另一方面,纯氮化铝的 320 ℃ 值非常可观,介于 GaN(250 ℃)和 SiC(490 ℃)之间。
Jena 和 Doolittle 表示,最终目标是商用 AlN 功率晶体管,其性能大大优于现有的选择,而名古屋的工作毫无疑问最终会实现这一目标。“目前这只是工程,”Doolittle 说。他们都指出,名古屋二极管是垂直器件,这是功率半导体的首选方向。在垂直器件中,电流从基板向上直接流到器件顶部的触点,这种配置允许最大电流流动。
近年来,至少有六种基于 AlN 的晶体管被展示,但这些晶体管都不是垂直器件,也没有一个具有与商用 GaN 或 SiC 晶体管竞争的特性。他们在设备的关键组件中也采用了 AlGaN。
名古屋论文的合著者、IEEE 会员Takeru Kumabe在给IEEE Spectrum的电子邮件中写道:“我们相信利用分布式极化掺杂技术展示具有商业竞争力的[功率晶体管]...... 基于 AlN 的垂直异质结双极晶体管由两个p - n结组成,具有良好的功率和面积效率,是我们的目标器件,也是我们要实现的梦想。”
Kumabe 补充说,为了实现这个梦想,团队将专注于更深入地了解电荷迁移率、“载流子寿命、临界电场和深层缺陷”。还应该开发能够生产高质量器件层并在加工过程中引入更少损坏的晶体生长和器件制造技术。”
“我们希望在 3~5 年内解决这些问题,并在 2030 年代实现基于 AlN 的功率器件的商业化,”他说。
三、全球首个氮化铝晶体管
在2022年4月,NTT Corporation宣布,其已使用高品质氮化铝(AlN)实现了晶体管的运行。
晶体管是半导体功率器件的重要组成部分,用于家用电子设备和电动汽车中的功率转换,其效率的提高将有助于节能。用于超宽带隙(UWBG)半导体的AlN具有大的击穿电场,因此是用于实现低损耗、高压功率器件的有前途的半导体材料。
据报道,NTT 已利用金属有机化学气相沉积(MOCVD)成功生产出高质量的 AlN,并开发了欧姆和肖特基接触的形成方法。这些技术使我们能够首次展示 AlN 晶体管。此外,即使在500°C的高温下,AlN晶体管也表现出良好的器件特性。这些成果将有助于实现超低损耗功率器件和高温电子器件。
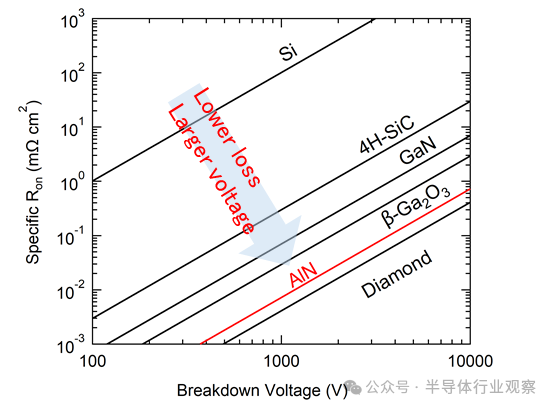
图3:每种半导体材料的特定导通电阻和击穿电压之间的关系
NTT Corporation表示,用于功率转换的半导体功率器件广泛应用于家用电子产品、个人电脑和智能手机、以及数据库服务器和电动汽车。近年来,功率器件的应用已扩展到光伏发电、铁路等大功率运行领域。为了实现碳中和,电力设备的损耗应该进一步减少。硅(Si)通常用于半导体功率器件。通过使用具有大击穿电场的宽带隙半导体,可以减少损耗并提高击穿电压。
因此,正在开发用于功率器件的宽带隙半导体,例如碳化硅(SiC)和氮化镓(GaN)。击穿场大于SiC或GaN的UWBG半导体进一步提高了功率器件的性能(图3)。UWBG 半导体包括 AlN、金刚石和氧化镓 (Ga2O3 )(表 I)。对于AlN功率器件,理论上功率损耗预计仅为Si的5%、SiC的35%、GaN的50%。
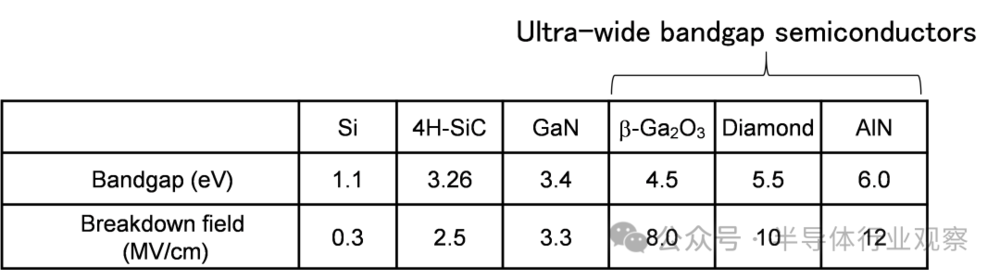
表1:半导体材料的带隙能和击穿场
自一个多世纪前首次合成以来,AlN 一直被用作绝缘体。2002年,NTT在世界上首次成功制造出半导体AlN,从而开辟了半导体器件应用的新途径。在UWBG半导体中,AlN的优点在于可以在大规模晶圆上制造器件,并且可以通过与其他氮化物半导体(例如GaN)形成异质结来获得各种器件结构。然而,关于这方面的功率器件制造的报道很少,并且其特性需要改进。
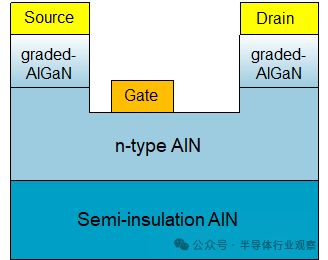
图4:AlN 晶体管示意图
NTT 首次使用 MOCVD 制造的高质量半导体 AlN 成功实现了具有良好特性的晶体管运行。AlN晶体管的电流-电压特性显示出良好的欧姆特性(图4和图5)和极小的漏电流。击穿电压高达1.7kV。
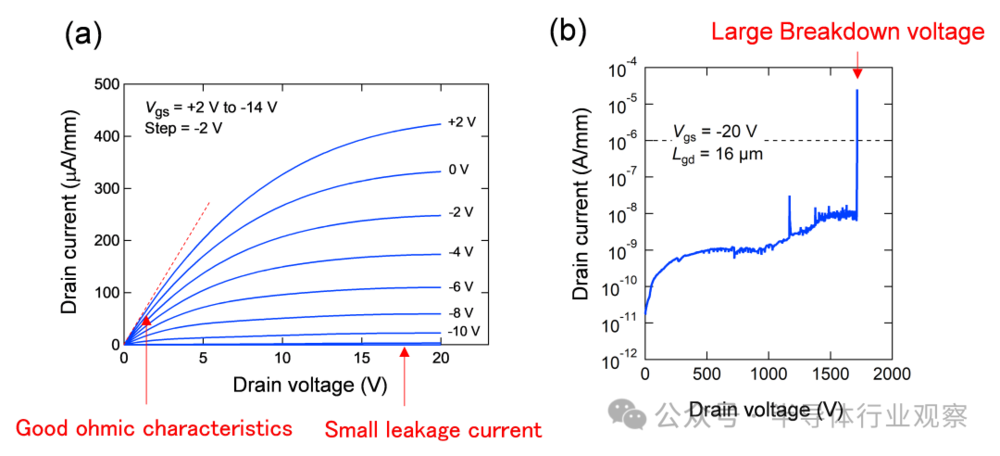
图5:(a) AlN 晶体管的漏极电流与漏极电压特性;(b) AlN晶体管的断态击穿特性。
NTT在新闻稿中强调,他们还证实了AlN晶体管可以在高温下稳定工作(图6)。与传统半导体材料相比,AlN 晶体管在高温下表现出更好的性能。随着环境温度从室温升高到 500°C,漏极电流增加到约 100 倍。此外,即使在500℃下,漏电流也保持在10 -8 A/mm的极低水平。结果,在500℃下获得了106的高漏极电流开/关比。
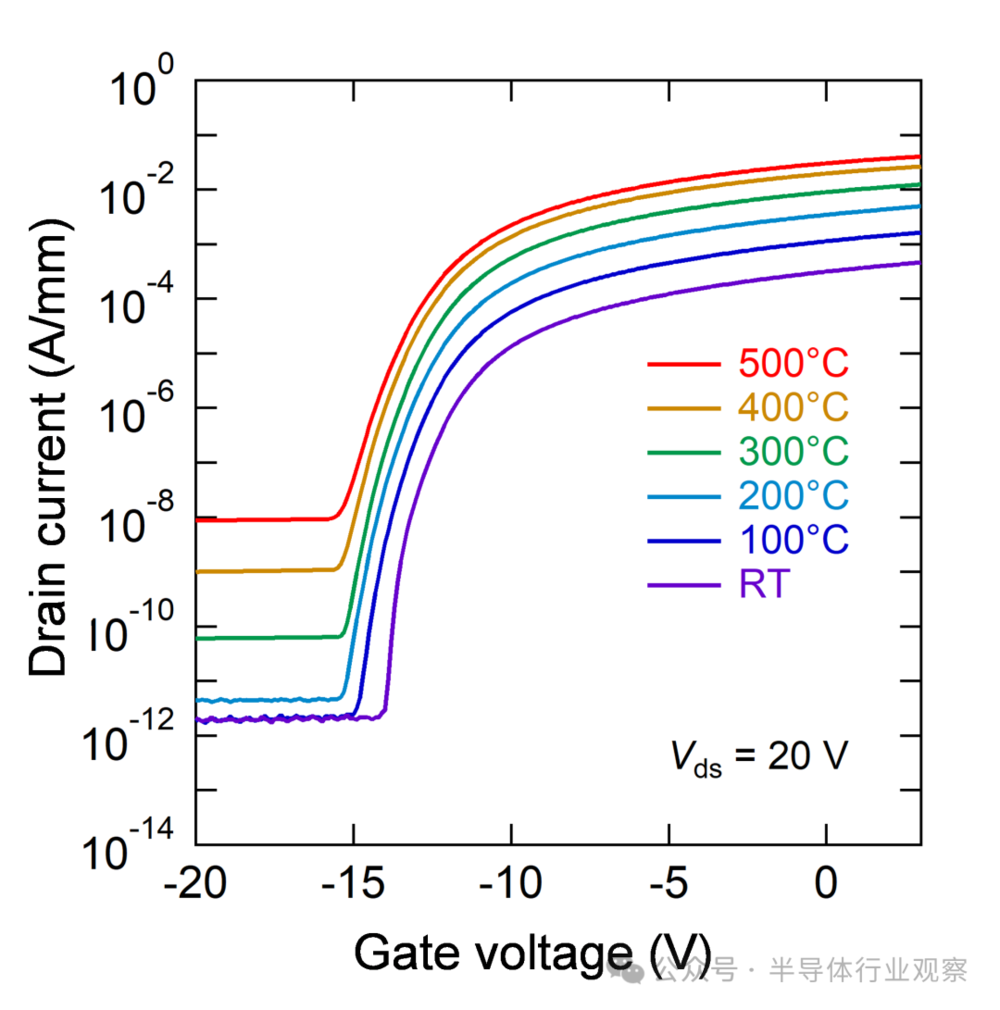
图6:AlN 晶体管在室温 (RT) 至 500°C 范围内的漏极电流与栅极电压特性
在NTT看来,要实现氮化铝,需要解决以下技术问题:
首先要解决的技术问题是高质量AlN的晶体生长技术。通过采用特殊设计的反应器开发独特的高温 MOCVD,降低了 AlN 中残留杂质和晶体缺陷的密度。由此,NTT 实现了具有世界最高电子迁移率的高质量 n 型 AlN 半导体。
第二点是如何实现良好的欧姆接触。AlN对金属具有较大的能垒,使其难以在其上形成欧姆接触。NTT 在 AlN 和金属电极之间使用了成分梯度的 AlGaN 层,以获得良好的欧姆接触(图 7)。
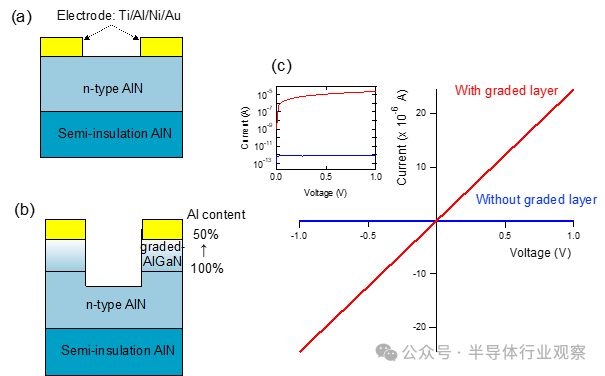
图 7:金属/n 型 AlN 接触结构(a)具有和(b)不具有成分渐变的 AlGaN 层。(c) 有和没有梯度层的电流-电压特性。
第三点是如何实现肖特基接触良好的整流。肖特基特性受半导体的晶体质量、半导体与金属电极之间的界面状态以及欧姆电极的接触电阻的影响。如上所述,由于高质量的AlN和良好的欧姆接触,NTT实现了近乎理想的肖特基特性和良好的整流性。
这些基本技术的建立导致了 AlN 晶体管的成功运行。在这些厂商和研究机构的努力下,半导体的未来指日可待。
参考链接:
1. https://spectrum.ieee.org/aluminum-nitride
2. https://group.ntt/en/newsrelease/2022/04/22/220422a.html
本文来自微信公众号:半导体行业观察 (ID:icbank),作者:IEEE
